
在半导体封装向高密度、微型化迈进的进程中,传统刚性治具已无法满足FPC软性线路板的精密加工需求。东莞路登科技创新研发的第三代自适应封装治具通过磁-热-力三位协同技术,实现了0.05mm超薄FPC的零损伤封装,将晶圆级封装良率提升至99.5%以上。
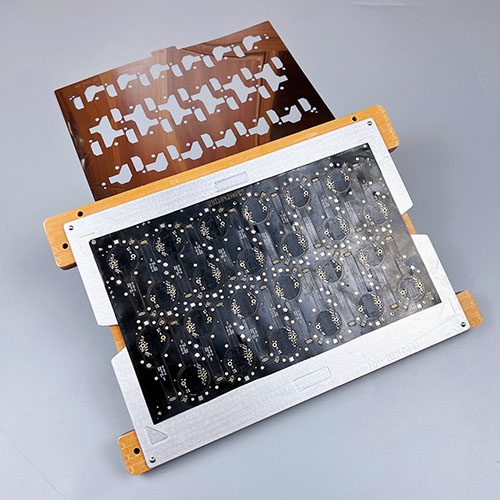
技术突破重构行业标准
纳米级接触控制
采用微孔阵列真空吸附+边缘磁力补偿双模系统,解决FPC翘曲导致的贴装偏移问题,芯片定位精度达±1.5μm,较传统方案提升3倍。
智能材料创新
基板集成石墨烯温控层,在-196℃~300℃环境下保持热膨胀系数小于0.5ppm/℃,匹配半导体级封装工艺窗口。
全流程兼容设计
可换式磁极模块,支持从QFN到BGA等12种封装形式切换,单套设备满足5G射频模组、折叠屏驱动IC等前沿需求。

产业应用实证
某国际封测龙头采用该方案后,FPC基板封装周期缩短至8秒/片,且因治具无金属离子污染特性,使芯片可靠性测试通过率提升至98.7%。
智造新纪元
我们正开发数字孪生系统,通过实时监测FPC形变数据动态优化治具参数,推动半导体封装进入柔性智能时代。